
TECHNIQUE
技術情報
【ウェハ】目標膜厚3μmに対して膜厚分布±3-5%以下を実現。硫酸銅めっき実験結果例

多くの大学や研究機関で導入いただいている当社のシリコンウェハ用めっき装置ですが、ここでは実際に装置を使用し行った実験のデータをご紹介します。
今回は8inch用の標準ウェハ用めっき装置を使用し、目標膜厚は3μmで実験を行いました。
〇使用装置
〇めっき条件
| めっき液 | 硫酸銅めっき液(光沢浴;市販品) |
| 使用サンプル | 8inch シリコンウェハテストピース |
| 電流密度 | 1A/dm2 |
| 目標膜厚 | 3 μ m |
| 陽極 | 含燐銅 |
| 液温 | R.T. (25ºC ± 1ºC) |
| 撹拌 | 空気撹拌+パドル撹拌 |
〇サンプル仕様
| サンプルサイズ | 8inch |
| パターン及びウェハ仕様 | 八角・四角配線(渦巻) |
| ライン幅(L/S) | 5〜100 μm |
| 丸型・四角バンプ | 10〜500 μm |
| ウェハ厚さ | 725 μm |
| 銅スパッタ | 300nm |
| レジスト厚 | 5 μm |
〇サンプル外観・めっき後の状態

左下:パターン中央部の被膜状態(3D) 右下: パターン中央部の被膜状態拡大図
〇サンプルポイント
めっき後、以下の9点のめっき膜厚を測定しました。
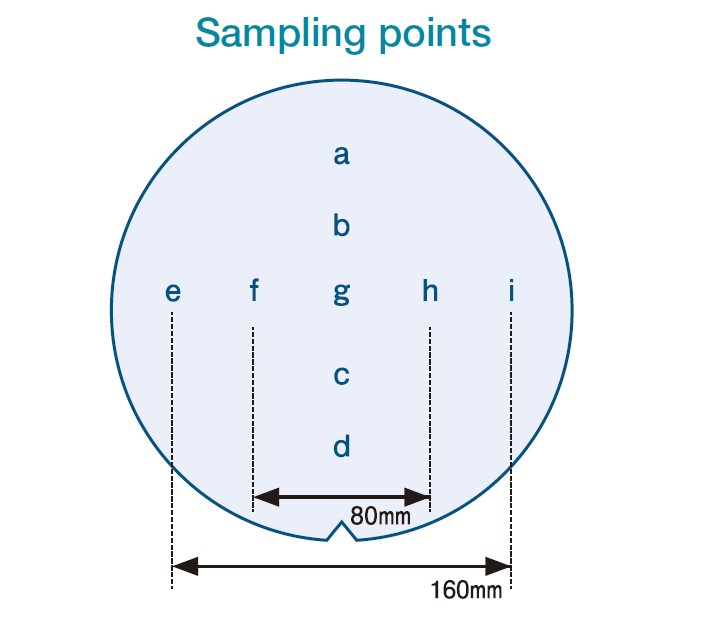
〇めっき膜厚測定結果
各サンプルポイントのめっき膜厚の数値は以下の通りです。
めっきターゲット3μmに対して膜厚分布±3-5%以下を実現しました。
| □40㎛ | □100㎛ | |
| a | 3.012 | 3.006 |
| b | 3.006 | 2.934 |
| c | 3.036 | 2.857 |
| d | 2.959 | 2.871 |
| e | 3.189 | 3.026 |
| f | 3.191 | 3.023 |
| g | 2.961 | 2.975 |
| h | 2.929 | 2.867 |
| i | 3.072 | 2.856 |
| Ave | 3.039 | 2.935 |
| Max | 3.191 | 3.026 |
| Min | 2.929 | 2.856 |
| Ran | 0.262 | 0.170 |
めっき膜厚(μm)